化學機械研磨漿料(CMP SLURRY)的穩定性
分散劑聚合物分子量的影響

一、背景介紹
化學機械研磨(CMP)是半導體製造中用於使晶圓或其他基材變平坦的技術,利用這種方法研磨削去材料,並使不平整的表面平坦化,使晶圓在埃氏等級(Angstrom level)上變得平整。
氧化鈰(IV),或稱為二氧化鈰,是稀土金屬鈰的氧化物,它以對氧化膜具有高拋光效率而聞名,但同時由於其顆粒容易快速沉澱和聚集而限制其在化學機械研磨工藝的發揮。若其不穩定便會在研磨過程中產生對研磨晶圓不利的磨損刮痕,因此必須調整鈰懸浮液漿料的配方,以滿足CMP應用的穩定性要求。
一般我們會使用聚合物分散劑以增加顆粒立體障礙的方式穩定鈰顆粒,因此分散劑的分子量應當會影響其穩定效果,本篇文章中我們將探討分散劑的分子量對CMP漿料穩定性的影響。
二、測試方法
使用Turbiscan LAB在35°C下分析了三種鈰懸浮液,連續測量12小時,其中A配方包含高分子量,B配方包含中等分子量,而C配方包含低分子量的分散劑。
三、實驗結果
1. 確認不穩定的原因
所有三種配方都呈現出相似的行為(參見下圖一):
- 在瓶頂部,由於顆粒發生沉降而從該區域流失,背向散射光信號下降。
- 與此同時,在瓶底,由於顆粒沉降,背向散射光訊號增強。
- 當頂部顆粒幾乎沉降至瓶子中下段,澄清程度提升至光能夠穿過樣品時,頂部的透射光訊號增加,此時應該就是肉眼可見的不穩定了。
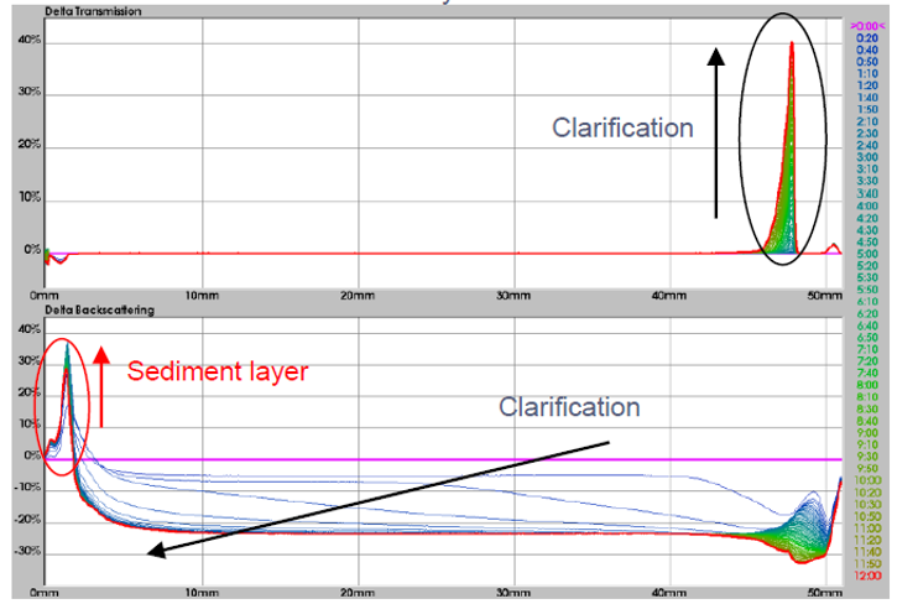
圖一
2. 樣品間比較
我們進一步比較了三種配方的沉降程度,可以從澄清層厚度對時間作圖的斜率(參見下圖二)計算出澄清速度(參見下表一)。
.png)
.png)
四、結論
通過使用Turbiscan LAB能夠確定樣品不穩定的原因並量化聚合物分子量對CMP漿料穩定性的影響。
